- +1
液晶与显示|晶圆级Micro-LED芯片检测技术研究进展
▍本文由论文作者团队(课题组)投稿
Micro-LED因其高集成度、高亮度、低功耗、自发光等优势受到广泛关注,有望成为新一代的主流显示技术。尽管市场前景广阔,但Micro-LED显示产业化进程却因整机成本过高而放缓脚步。导致其成本居高不下的原因之一是制造过程中涉及的有关材料、器件、工艺等复杂问题导致了最终的显示屏像素良率达不到要求。显示行业认为Micro-LED显示屏的像素良率至少要99.99999%才可以保证不影响观感。提升Micro-LED显示屏像素良率、避免巨量修复是降低Micro-LED整机成本从而实现产业化的关键。受限于LED外延片的生长工艺和后续的晶圆级芯片加工工艺,难以保证所有Micro-LED芯片的光、电参数满足要求。因此,在巨量转移-键合之前,对晶圆级Micro-LED芯片进行检测以实现坏点的拦截就成为提升Micro-LED显示屏良品率的关键环节。
目前,晶圆级Micro-LED检测手段分为接触型检测和无接触型检测。接触型检测的代表性方法为电致发光检测,即通过微型电学探针分别接触Micro-LED的两个电极并注入电流,记录LED芯片的电学性能和发光性能。无接触型检测的代表性技术为光致发光检测,该技术的原理是通过短波长激发Micro-LED芯片的多量子阱层实现发光,通过光致发光谱来评估LED的质量。除了这两种典型的检测技术外,还存在以摄像系统与机器学习为核心的自动光学检测、红外热成像检测、阴极荧光检测、飞行时间二次离子质谱检测等方法。此外,极具前瞻性的无接触电致发光检测技术也正加速发展,具有高效率、高准确率的无接触电致发光检测将是适配晶圆级Micro-LED芯片检测的极佳方案。目前的检测技术研究百家争鸣,但尚无对现有的检测技术进行总结与分析。
近日,福州大学、闽都创新实验室郭太良教授团队在《液晶与显示》(ESCI、Scopus,中文核心期刊)2023年第5期发表了题为“晶圆级Micro-LED芯片检测技术研究进展”的综述,并被选作当期封面文章。郭太良教授、吴朝兴教授为该文通讯作者、研究生苏昊为该文第一作者。该文首先介绍了晶圆级Micro-LED检测时所需要检测的几个指标,其次详细介绍并分析现有的检测手段,最后对LED检测技术进行总结并提出该领域未来发展方向的展望。

图1:《液晶与显示》2023年第5期封面图
▍Micro-LED检测技术简介
Micro-LED芯片的质量是影响Micro-LED显示屏质量的重要因素,是决定Micro-LED显示的整机成本能否有效降低并实现产业化的关键。然而,受限于LED外延片的生长工艺和后续的芯片加工工艺,无法保证所有Micro-LED芯片的光、电参数满足要求。因此,在巨量转移之前,对晶圆级Micro-LED芯片进行检测以便实现坏点的拦截就成为提升Micro-LED显示屏良品率的关键环节。然而,随着LED芯片的尺寸越来越小,一个显示器上所需要的LED芯片数量也日渐增多。这对现有的晶圆级Micro-LED缺陷检测手段提出了极高的要求。
目前,晶圆级Micro-LED检测手段分为接触型检测和无接触型检测。接触型检测的代表性方法为电致发光检测,即通过微型电学探针分别接触Micro-LED的两个电极并注入电流,记录LED芯片的电学性能和发光性能。此外,无接触型检测技术也在逐渐发展。无接触型检测的代表性技术为光致发光检测,该技术的原理是通过短波长激发Micro-LED芯片的多量子阱层实现发光,通过光致发光谱来评估LED的质量。除了这两种典型的检测技术外,还有以摄像系统与机器学习为核心的自动光学检测(AOI),以及极具前瞻性的无接触电致发光检测技术。
▍Micro-LED检测技术研究现状
| 接触型检测 |
接触型检测的代表性方法为电致发光检测。该检测技术使用的主流方法是使微型探针与Micro-LED的电极进行接触,然后通过在探针上施加直流电压使外部载流子注入到Micro-LED的发光层中,使其发生电致发光现象,然后收集Micro-LED的工作电压、亮度、发光波长等光电参数来判断芯片合格。这种检测方式原理简单,技术成熟,但在检测过程中要对探针进行垂直移动,在进行垂直移动的过程中会不可避免地对Micro-LED芯片的电极、表面,以及探针造成一定程度的损坏。此外,Micro-LED尺寸通常在50 μm以下,这导致探针与Micro-LED芯片电极的对准难度也加大,造成检测效率低下、成本急剧增加。为此,研究人员从检测效率提升、损伤抑制等方面开展研究。
• 检测效率提升
设计特殊的电极结构并通过显微镜对包含多颗Micro-LED的图像进行处理并筛选出亮度不正常的芯片也可以提高检测效率。研究人员提出了一种可以测量整个Micro-LED阵列乃至单颗Micro-LED芯片表面亮度分布的检测方法。Micro-LED阵列(如图2(a)所示)由行列电极进行选通,因而可以满足单个Micro-LED芯片点亮和多个Micro-LED芯片同时点亮需求,并在两种不同情况下使用测量系统进行检测。摄像系统获取发光的Micro-LED阵列图像并由算法系统生成伪彩色图(如图2(b)所示),从伪彩色图可以看出,随着电流密度增大,Micro-LED表面亮度的均匀性增大。这个方法在检测方面可以精确地表征单颗LED芯片的亮度均匀性情况,也可以同时表征多颗LED芯片的亮度均匀性情况。不足之处是制作多行多列的电极成本较高,且后期还需要去除这些过渡性的电极。

图2:(a)Micro-LED阵列的显微图像;(b)单个微型LED芯片的亮度伪彩色图和3D分布图
图源:IEEE ACCESS,2018,6:51329-51336. Fig.7,8
• 损伤抑制
覆盖与LED芯片电极形状相适配的透明导电膜可以在测试过程中保护LED芯片的电极不被损坏,减少成本,透明导电膜覆盖LED芯片的示意图如图3(a)所示。研究人员提出了一种LED芯片的无损测试方法。该方法使用了透明导电膜覆盖待测LED芯片,测试针通过导电膜与LED芯片间接接触,从而避免了传统针测中会出现的针痕问题,如图3(b)与图3(c)所示。该导电膜具有透明导电槽,导电槽分为正极导电槽和负极导电槽,分别对应于LED芯片的正电极和负电极。其形状与尺寸与待测LED芯片一致,深度与待测LED芯片电极厚度一致,再把这些经过特殊制备的透明导电膜蚀刻在绝缘基底上,测试时LED芯片的电极嵌入透明导电槽,测试针再扎到这些与LED正负电极接触的区域,进行测试。这种方案原理简单、效果好,但是与诸多使用“介质”隔开探针与LED芯片、Micro-LED芯片的方法一样,一种规格的导电膜只能适配一种规格的芯片,适用性低,并且随着LED芯片尺寸越来越小,制备与之相适配导电介质的难度也会越来越大。
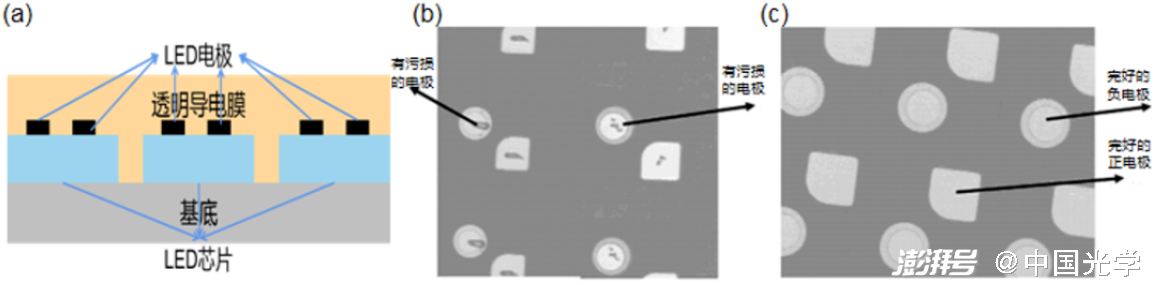
图3:(a)采用透明导电膜的检测原理示意图;(b)针测后的LED电极光学显微照片;(c)使用透明导电膜进行针测后的LED电极光学显微照片
图源:液晶与显示,2023, 38(5):582-594. Fig.2
中国专利:一种LED芯片的无损测试方法. Fig.2
| 无接触检测 |
• 无电学接触电致发光检测
2015年,福州大学郭太良、吴朝兴团队提出了一种晶圆级Micro-LED芯片无接触电致发光检测技术。该技术可以对晶圆上百万数量级的Micro LED芯片进行扫描式、无接触电致发光检测。无接触电致发光检测理论是一种最高效、最准确的检测方式。该技术既可以避免光致发光导致的良品率虚高问题,又无需保证探针与芯片的精确接触,因而检查速度最快。无接触电致发光原理如下:当外加电场方向从p-GaN指向n-GaN时,n-GaN区域内的电子与p-GaN区域内的空穴通过扩散运动向多量子阱(MQWs)方向移动,在量子阱中发生辐射复合,如图4(a)所示。在正向偏压下并不能持续发生辐射复合现象,也就是说施加直流电压或处于交流驱动正半周期时只能观察到一次发光。这是因为多数载流子的漂移会在Micro-LED两端形成耗尽区,并产生一个感生电场屏蔽外电场,阻止载流子扩散。因而必须施加一个反向电场来驱动电子空穴回到初始状态(图4(b))。因此该检测技术需要施加交流电场才能使待检测的Micro-LED周期性发光。LED无接触电致发光可以用以下方程描述。

在无接触电致发光检测过程中,使用电极场板来与LED芯片发生耦合,如图4(c)所示。外部高频电源施加在场板电极与LED芯片阵列的底部电极上,使得场板下方的LED芯片阵列同时发光,通过相机收集图像并检测LED芯片的亮度参数。图4(d)是福州大学研究人员所展示的晶圆级无电学接触电致发光检测效果。图4(d)上图是待检测的Micro-LED阵列示意图和单个器件实物图。所检测的芯片为4英寸晶圆上的正装Micro-LED,芯片尺寸为40 μm×20 μm。图4(d)下图是实际检测效果。
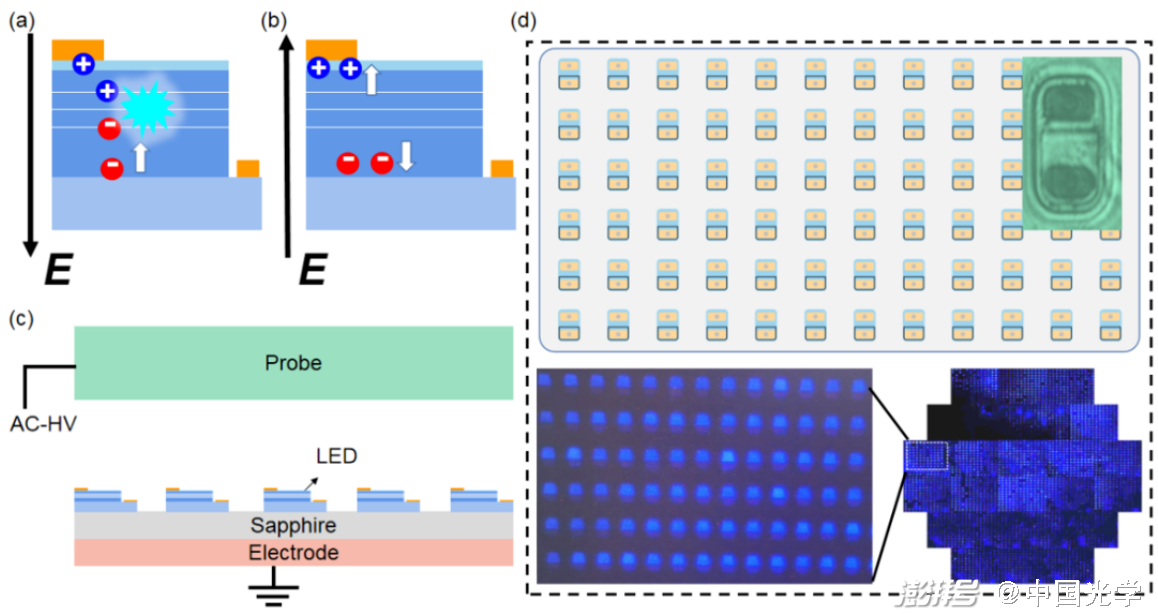
图4:(a)无接触Micro-LED在正向电场下的工作示意图;(b)无接触Micro-LED在反向电场下的工作示意图;(c)晶圆级Micro-LED的无接触电致发光检测原理图;(d)待检测的Micro-LED阵列示意图与Micro-LED阵列检测效果图
图源:液晶与显示, 2023, 38(5):582-594. Fig.3
• 光致发光检测
光致发光(PL)检测是无接触检测中一种常用的检测方式。其原理如图5(a)所示,即使用短波长光(如紫外光)激发LED的发光层的电子使其辐射跃迁。进而产生发光图像并从发光图像中筛选出损坏的LED芯片。使用PL图像和阴极荧光(CL)成像来代替电致发光检测,同样实现无损检测的想法,PL图像与CL图像分别如图5(b)、图5(c)所示。对于同一个多像素LED样本,使用短波长的光激发时,所有像素都会发光,但在使用CL成像时并非所有像素都被点亮。对此的解释是,PL的整个过程并没有发生载流子运输,因而不受LED像素在刻蚀过后产生的各种短路缺陷的影响。实验发现71.75%的像素在CL图像与EL图像中都会发光,说明CL图像能一定程度上与EL检测结果拟合,但拟合度还需进一步提高。
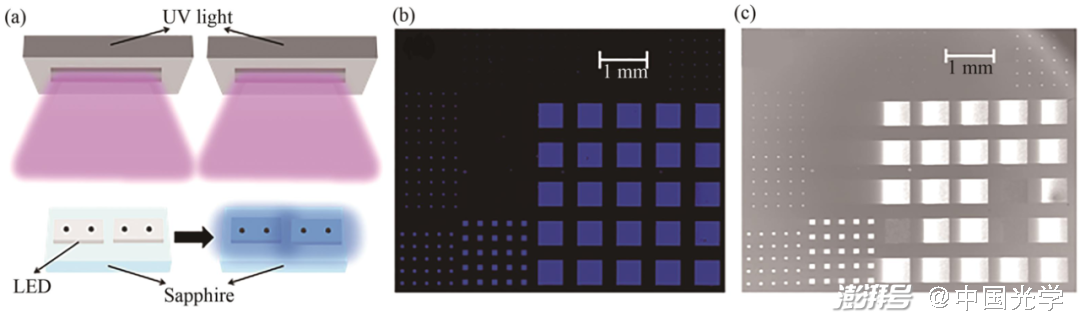
图5:(a) PL 检测原理示意图;(b)PL检测图像;(c)阴极荧光图像
图源:Journal of the Society for Information Display,2021,29(4):264-274. Fig.3
• 自动光学检测
AOI是现在市面上普遍使用的一种LED缺陷检测技术。它多使用于识别刚切割后的晶圆片上带有表面缺陷的LED像素,或者与点亮的LED芯片阵列相结合,检测、识别不亮或亮度较暗的LED芯片,将其识别为坏点。随着卷积神经网络的发展,AOI系统的效率和精度也越来越高,不同的算法也能够适应不同的检测需求。
▍总结与展望
从产业成熟度、耗材经济性、检测效率、技术简易度、检测准确度、检测全面性来对四种常见的晶圆级Micro-LED芯片检测技术进行综合对比,如图6所示。产业成熟度方面,自动光学检测与光致发光检测在市面上已有诸多成熟的检测设备。耗材经济性上,无接触电致发光检测、自动光学检测与光致发光检测都不会与待测样品进行接触,因而也不会造成机械性损坏,可以有效减少耗材成本。同时,无接触电致发光检测、自动光学检测与光致发光检测不需要进行频繁的垂直方向移动,并且可以实现Micro-LED芯片阵列的检测,因此具有较高的检测效率。自动光学检测的核心是深度学习算法与显微摄像系统,因此其在技术简易度方面有着先天的优势。对于检测准确度,有接触电致发光检测与无接触电致发光检测都以电致发光为基础,因而可以有效拦截无法正常发光的芯片,具有较高的检测准确率。最后是检测全面性,有接触电致发光检测过程与Micro-LED芯片实际应用情景一致,可以得到Micro-LED芯片完整的电学、光学参数。

图6:各类检测技术对比图
图源:液晶与显示, 2023, 38(5):582-594. Fig.6
接触型电致发光检测可以准确获得Micro-LED芯片工作时的电学参数(如电流密度、电压、反向漏电流等)以及发光时的波长、亮度等。然而,接触型电致发光检测容易对Micro-LED电极、芯片表面造成刮擦、挤压等损坏。同时,面对巨量的Micro-LED芯片检测存在效率低下的问题,显著增加了显示器件的制作成本。光致发光检测采用短波长、高能量的光来激发Micro-LED芯片中的获得LED芯片的吸收光谱、载流子寿命等,但并不能真实反映器件的工作状态。AOI检测技术只能筛选出有外观缺陷的LED芯片,无法筛选出不能发光的Micro-LED芯片。
Micro-LED厂商总是希望在保留接触型电致发光检测高准确度同时,提高检测效率、减少对芯片的损伤,即无接触电致发光检测方案。无接触电致发光检测的优势在于它可以避免漏检率过高的问题,可以较为准确地获得Micro-LED芯片的电致发光性能。同时,检测效率可以媲美光致发光检测和自动光学检测,可有效缩短工艺时间。此外,无接触电致发光检测可以实现批量的Micro-LED芯片检测(检测数量取决于检测探头的面积),并且不会对Micro-LED芯片施加任何外力,杜绝了由于检测而对芯片产生的额外损伤。随着Micro-LED在大屏幕、高清显示的迅猛发展,无接触快速电致发光检测方案是大势所趋。
▍论文信息
苏昊,李文豪,李俊龙,刘慧,王堃,张永爱,周雄图,吴朝兴,郭太良.晶圆级Micro-LED芯片检测技术研究进展[J].液晶与显示, 2023,38(5):582-594.
https://cjlcd.lightpublishing.cn/thesisDetails#10.37188/CJLCD.2022-0392
▍通讯作者

郭太良,研究员,博士生导师,全国优秀教师,闽都创新实验室副主任,国家新型显示技术创新中心副主任,平板显示技术国家地方联合工程实验室主任。主要承担了863重大专项、国家基金、福建省重大科技项目等20多项科研项目,研制出具有自主知识产权的可显示视频图像的20英寸单色、25英寸QVGA彩色、VGA彩色、SVGA彩色、34英寸XGA彩色场致发射显示器,以及5、10、20和34英寸FED背光源,为低成本、大尺寸FED显示器和背光源的研发和产业化开辟了一条全新途径。以排名第一获福建省科技进步一等奖,中国产学研创新成果二等奖各一项,授权发明专利100多件,发表学术论文280多篇。

吴朝兴,福州大学、福建省闽都创新实验室教授,博士生导师。长期从事光电器件与新型显示技术应用基础研究,聚焦纳米像元显示技术(NLED)及基于无载流子注入技术的光电材料分析测试研发。截止至2022年,获得中国授权发明专利23件,韩国授权发明专利5件,作为第一作者/通讯作者在 Nature Communications、Advanced Materials、ACS Nano、Nano Energy、Advanced Functional Materials等期刊发表论文70余篇。入选首批福建省“雏鹰计划”青年拔尖人才、福建省引进高层次人才(A类)、福建省“闽江学者奖励计划”。主持“十四五”国家重点研发计划项目、国家自然科学基金、福建省自然科学基金等,获得福建省自然科学优秀学术论文一等奖、韩国研究开发优秀成果奖。
本文为澎湃号作者或机构在澎湃新闻上传并发布,仅代表该作者或机构观点,不代表澎湃新闻的观点或立场,澎湃新闻仅提供信息发布平台。申请澎湃号请用电脑访问http://renzheng.thepaper.cn。




- 报料热线: 021-962866
- 报料邮箱: news@thepaper.cn
互联网新闻信息服务许可证:31120170006
增值电信业务经营许可证:沪B2-2017116
© 2014-2024 上海东方报业有限公司




